先進製程推動光阻周邊材料市場成長台廠下一個攻克目標
財經中心/綜合報導
隨製程越演先進,在半導體微影製程中除了光阻劑本身外,另有一系列光阻周邊材料扮演關鍵角色,包括表面改質劑(Rinse)、洗邊劑(EBR)、底部抗反射層(BARC)、頂部抗反射層(TARC)、稀釋劑(Thinner)以及光阻剝除劑(Stripper)等。根據研調機構Deloitte 及WSTS 資料顯示,2025 年全球黃光微影材料中,光阻及光阻周邊市場規模達67 億美元,預估至2030 年市場規模將進一步成長至96 億美元。除光阻劑市場規模增長,製程節點逐漸縮小,先進製程的高良率要求亦推升對 Rinse、BARC 等提升良率材料的用量,對於光阻周邊材料的材料精密度亦有所提升。

光阻周邊材料在製程中各有不同功能。Rinse 為表面改質劑,為黃光微影製程中用來提升良率的關鍵特化材料,可大幅改善晶圓缺陷、線槽坍塌的問題;BARC 為底部抗反射層,透過吸收或破壞性干涉,降低反射光強度,以增進光阻成像能力,提升圖形邊緣的垂直度與完整性,並且在多層光阻結構中,BARC 可有助於控制各層之間的光學干涉,減少由於反射引起的圖形不一致性,進而提升製程良率;EBR 又稱為晶邊清洗劑,是一種溶劑型化學品,用途在於移除晶圓邊緣厚厚一圈的光阻,避免邊緣堆疊對製程產生影響。
Investment Summary
光阻周邊材料市場集中度高,主要由少數日、美、德大廠壟斷主要份額,國外廠商如美商Merck、美商杜邦、日商東京應化等。但在半導體在地化趨勢下,亦為台廠帶來新契機,相關廠商如新應材(4749 TT)。Rinse 為目前新應材(4749 TT)主要產品,佔有公司整體營收約7 成,新應材已成為台系晶圓廠N3 Rinse 獨家供應商,預期N2 量產後,亦能持續維持獨供地位,將自2026年進一步貢獻營收。另外在N2 製程中,新應材同時亦供應新品BARC 及EBR。根據法人研究部通路訪查,預估光阻周邊產品Rinse/BARC/EBR)在3nm 及2nm 的用量比為1.0:1.7,其中用量增加部分為BARC 及EBR,隨N2 產能放量,新品BARC 及EBR 將能挹注公司整體營收動能。

光阻周邊市場份額集中度高,台廠迎來新契機
隨製程越演先進,在半導體微影製程中除了光阻劑本身外,另有一系列光阻周邊材料扮演關鍵角色,包括表面改質劑(Rinse)、洗邊劑(EBR)、底部抗反射層(BARC)、頂部抗反射層(TARC)、稀釋劑(Thinner)以及光阻剝除劑(Stripper)等。根據研調機構Deloitte 及WSTS 資料顯示,2025年全球黃光微影材料中,光阻及光阻周邊市場規模達67 億美元,預估至2030 年市場規模將進一步成長至96 億美元。除光阻劑市場規模增長,製程節點逐漸縮小,先進製程的高良率要求亦推升對 Rinse、BARC 等提升良率材料的用量,對於光阻周邊材料的材料精密度亦有所提升。光阻周邊材料市場集中度高,主要由少數日、美、德大廠壟斷主要份額,國外廠商如美商Merck、美商杜邦、日商東京應化等。但在半導體在地化趨勢下,亦為台廠帶來新契機,相關廠商如新應材(4749)。

防光阻塌陷就靠Rinse
Rinse 又稱為表面改質劑,為黃光微影製程中用來提升良率的關鍵特化材料,可大幅改善晶圓缺陷、線槽坍塌的問題。晶圓表面相對惰性,隨製程越演先進,光阻厚度越來越薄,圖形越精細,光阻直接塗佈容易剝離,Rinse 的主要目的之一就是為了改善光阻與基材的附著性,在表面形成一層親有機層,提供鍵結界面以防止其旋塗後剝離或圖形崩塌。另外,Rinse 亦使光阻在旋塗(spincoating)時形成均勻薄膜,避免氣泡或脫膜,進而改善濕潤性與均勻塗佈性。Rinse 亦可提供疏水
層,防止水汽或污染吸附,避免表面吸濕影響後續曝光品質。簡而言之,Rinse 功能具有 1) 良率提升:減少光阻崩塌、圖形崩塌與污染,提高曝光與蝕刻品質;2) 線寬控制精度提升:提供表面均勻性,保護高解析圖形邊緣,有助於微細圖形邊緣銳利度。
在3M 退出全球Rinse 市場後,目前Rinse 主要供應商有美商Merck(MRK US)及台廠新應材(4749 TT)。在半導體供應鏈在地化趨勢下,台系晶圓廠積極與新應材合作共同開發Rinse 產品,新應材目前已於台系晶圓廠N3 製程實現獨供,預期N2 亦將能持續維持獨供,自2026 年進一步貢獻營收。
BARC 減少反射光強度 優化微影成像能力
BARC 為底部抗反射層,是在預處理技術(塗底)時使用的一種材料。晶圓表面具有高反射性,容易產生如駐波效應的垂直方向干涉現象(Standing Wave Effect),導致光阻圖形邊緣粗糙(lineedge roughness)或反射凹陷(notching)。BARC 透過吸收或破壞性干涉,能有效抑制光源在基板上的反射,降低反射光強度,以增進光阻成像能力,提升圖形邊緣的垂直度與完整性,並且在多層光阻結構中,BARC 可有助於控制各層之間的光學干涉,減少由於反射引起的圖形不一致性,進而提升製程良率。簡而言之,BARC 在半導體微影製程中扮演著至關重要的角色,尤其在先進製程節點中,對圖形解析度、製程穩定性和良率的提升具有不可替代性。隨著製程演進對BARC 的性能要求持續提升。
BARC 供應商除了有日商日產化學(4021 JP)及美商陶氏化學(DOW US)握有大宗市場份額,台廠新應材(4749 TT)亦將於台系晶圓廠供應N2 所需之BARC,國泰證期研究部預期未來將持續擴展市場份額。
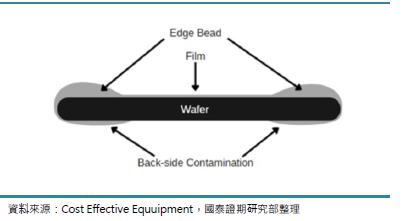
EBR 為避免光阻堆疊大功臣
EBR 又稱為晶邊清洗劑,是一種溶劑型化學品,由於旋塗中會產生離心力,光阻可能會在晶圓邊緣堆積,堆積厚度可能達到光阻標準厚度的數倍,除了邊緣光阻外,光阻亦可能會包裹在晶圓邊緣,進而污染晶圓的背面,若是不除去可能造成承接晶圓的機械手臂無法精準拿取。在此情況下恐對光阻處理系統和曝光工具造成污染,並可能對微影之外的製程設備造成問題。EBR 用途在於移除晶圓邊緣厚厚一圈的光阻,避免邊緣堆疊對製程產生影響,防止機械手臂於裝載晶圓或進行熱處理時抓取不準,或將粒子帶入蝕刻/沉積設備內造成缺陷與維修成本,進而提高製程良率及降低製造成本。
目前EBR 供應商中,海外廠商有美商Merck(MRK US)、日商東京應化(4186 JP)、JSR(4185 JP)等業者,台廠新應材(4749 TT)亦將於台系晶圓廠供應N2 所需之EBR,預期出貨量將隨N2 量產而提升。




